

|
EM-KLEEN / SEMI-KLEEN
リモートプラズマクリーナー『EM-KLEEN』『SEMI-KLEEN 』は、分離されたプラズマソースとコントローラで構成され、ソースはFE-SEMやXPS, EPMAなどの試料チャンバーもしくは試料交換室などに接続されます。接続された試料チャンバーやチャンバー内の試料をプラズマクリーニングすることで、高真空装置におけるカーボン系コンタミネーションを予防・除去します。
|
||
|
ターボ分子ポンプ領域で運転可
|
プラズマソースを設置した試料室の真空度が、0.1mTorr~2Torrレンジでプラズマ点火が可能です。 ※設置する装置や設置箇所(試料室/交換室)、使用目的によって条件は大きく異なります。詳細は別途お問合わせ下さい。 |
秀逸なユーザーI/Fデザイン
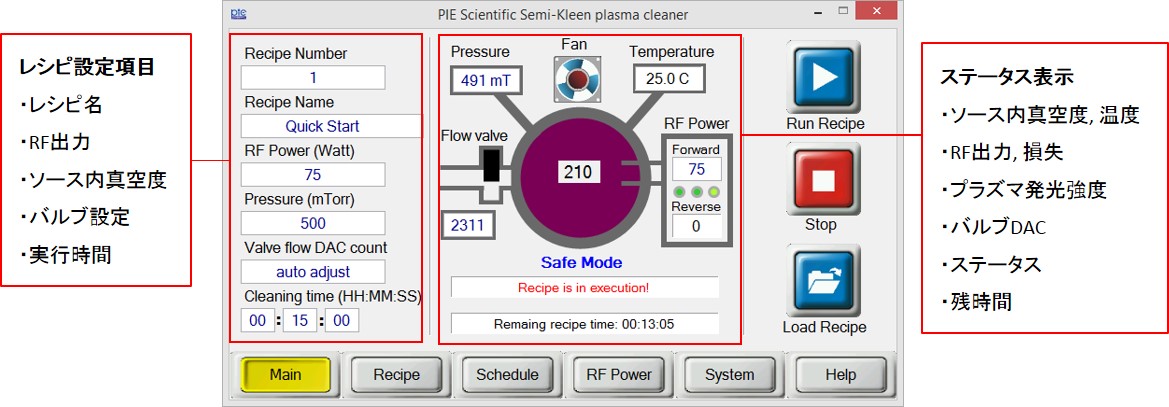
|
超Highスピードクリーニング
|
使用済みのアパーチャープレートのように、クリーニング対処物がひどく汚染されている場合、プラズマソースとアダプタの間の「ブースターチューブ」内でクリーニングすることで、超高速クリーニングが可能です。 |
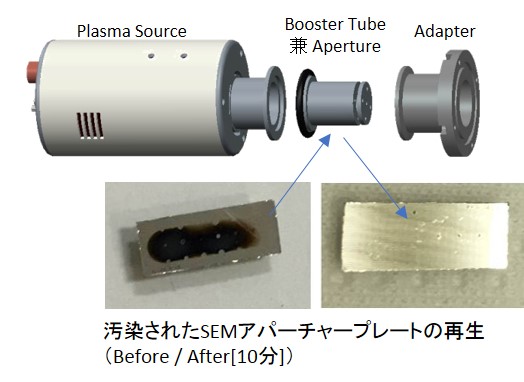
|
SafeモードとExpertモード
|
高電圧がかかる検出器を備えたFE-SEMのような分析装置で、ユーザーが装置自体に不慣れな場合、より安全にクリーニングを実施するためのモードが「Safeモード」です。 |
選べるコントローラ

|

|
| 19"ラックモデル(オプション) | ポータブル卓上モデル |
マスフロー制御ガス混合器(オプション)
|
Airを導入して行うプラズマクリーニングは、活性酸素による酸化反応によります。
■ タッチスクリーンI/F |

|
※ 酸素ガス、水素ガスを使用する場合は、プラズマ耐性の真空ポンプを使用して下さい。
※ 酸素ガス, 水素ガス等の使用は、ガスの安全マニュアルに沿ってご使用下さい。
製品ラインナップ

|
EM-KLEEN |
|
リモートタイプのベーシックモデル。一般的な高真空チャンバー向け。
|
|

|
SEMI-KLEEN quartz |
|
半導体インライン装置向け。ガス導入ラインにnmサイズのパーティクルを除去する超微細フィルターを搭載。
※また、自動インピーダンスマッチング機能も有り。SEMI-KLEEN Sapphireのように、特定用途向けにカスタマイズも可能です。例えば、SEMI-KLEENプラズマクリーナーは、ALDシステムでエッチング/デポジション用途として使用されています。 |
|

|
SEMI-KLEEN sapphire |
|
反応性ガス・腐食性ガスに適応するため、プラズマチューブにサファイアを使用。
(H2, NH3, NF3, CF4 etc) |
製品仕様
|
製品
|
EM-KLEEN | SEMI-KLEEN quartz | SEMI-KLEEN sapphire |
|
用途
|
SEM, TEM, XPS, SIMS, AES
|
SEM, TEM, XPS, SIMS, AES, CD-SEM, EB-Litho
|
ALD, EUV-Litho for NF3, CF4, NH3, H2, HF, H2S プラズマ
|
|
チャンバー
|
石英ガラスチューブ
|
サファイアチューブ
|
|
|
プラズマ方式
|
ICP(Inductively Coupled Plasma)[誘導結合型]
|
||
|
RF出力*1(@13.56MHz)
|
0~75 W
|
0~75 W(オプション:0~150 W)
|
|
|
動作真空度(ソース内)
|
7 mTorr ~ 1 Torr
|
||
|
真空チャンバー真空度
(ダウンストリーム側)*2 |
0.1 mTorr ~ 1 Torr
|
||
|
真空計
|
マイクロピラニゲージ内蔵、大気 ~ 1 e- 4 Torr
|
||
|
インピーダンス整合
|
固定
|
固定 or オート
|
|
|
腐食性ガス
|
不可
|
可
|
|
|
ソースマウント形状
|
NW / KF40(オプション:CF 2.75”[CF70])
|
||
|
PC制御
|
RS232 / RS485,Windows.Net Framework 4.0以上
|
||
|
コントローラ
|
可搬型、4 inch タッチパネル、シリアル通信ポート(D-sub9)
ソース ~ コントローラ間ケーブル 4.5 m |
||
|
プラズマソースサイズ
|
φ86×168 mm
1 kg |
140×105×190 mm
2.2 kg |
250×380×130 mm
2 kg |
|
標準コントローラサイズ
|
W 305×D 340×H 200 mm,7 kg
|
||
|
150W コントローラサイズ
|
-
|
W 220×D 380×H 130 mm,8 kg
|
|
|
電源
|
AC 90~250 V, 50/60 Hz,400 W以下
|
||
*1 RF出力:日本国内では、初期設定でRF出力を49Wまでに制限しています。
“高周波利用設備申請書”の届出により、制限を解除し、75W(オプション:150W)まで使用可能となります。
*2 真空装置の仕様(特にチャンバーサイズやポンプスピード)やソースの設置個所、使用目的や使用方法により大きく異なります。
PIE Scientific 社 <プラズマ処理によるコンタミネーション除去/表面処理>





