
|
実験のセットアップ |
|
|
以下の実験では、EM-KLENプラズマソースを小型の高真空チャンバーの上部に設置しました。UHV対応のアイソレーションバルブにより、EM-KLENはメインチャンバーから遮断されています。アイソレーションバルブは、プラズマクリーニング中のみ開きます。プラズマクリーニングが終了すると、アイソレーションバルブが閉じ、プラズマソースからメインのUHVチャンバーへのリークを減少させます。 |
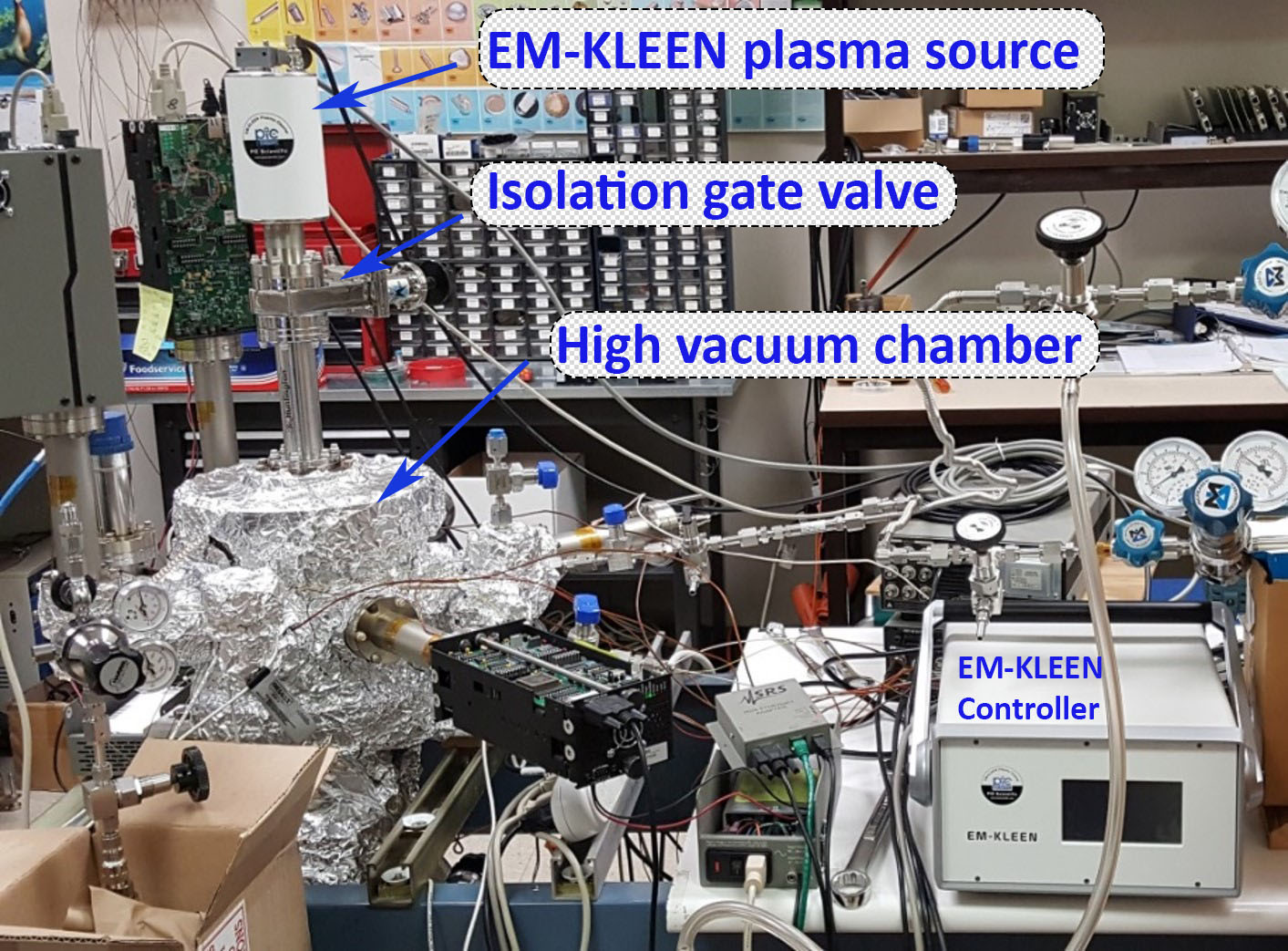
|
|
プラズマクリーニング前後のRGAスペクトル |
|
プラズマクリーニングステップの前後で、真空チャンバー内の残留ガス種を測定するために、複数のRGAがUHVチャンバーに設置された。通常、チャンバーベーキングの前には水、炭化水素、フルオロカーボンのピークが非常に目立ちます。250 ℃の高温チャンバーでのチャンバーベーキングとポンピングには1週間以上かかる場合もあります。しかし、常温の空気で25分間のプラズマクリーニングを行うと、水分量が大幅に減少し、RGAスペクトルから炭化水素とフルオロカーボンのピークがほぼ完全に除去されました。 |
|
|
|
プラズマクリーニング前のRGAスペクトル |
|
|
|
25分間のプラズマクリーニング後(プロセスガス:大気)のRGAスペクトル |
|
プラズマクリーニングによるポンプダウン時間の短縮と真空度の向上 |
|
プラズマクリーニングを実施する前のUHVチャンバーは、ベーキングとポンピングを7日間行っても、チャンバーが加熱されている状態では1.1×10-7Torrの圧力にしかなりませんでした。これは、ベーキングとポンピングを7日間行っても、チャンバー内に水分、炭化水素、フルオロカーボンが比較的高い濃度で存在していることを意味します。その後、EM-KLEENプラズマソースを設置するために、チャンバーを再び大気圧にベントしました。最初のポンプダウンの直後に、アルゴン80%、酸素20%のプロセスガスで真空チャンバーのプラズマクリーニングが4時間行われました。プラズマクリーニング後、チャンバーを2日間ベーキングしました。4時間のプラズマクリーニングと2日間のベーキングの結果、加熱されているチャンバーの圧力は2.4×10-8Torrに達しました。ベーキングの時間が7日から2日に短縮されたにもかかわらず、真空度は4倍以上に向上しました。プラズマクリーニングは、通常のチャンバーベーキングよりもはるかに高速にUHVチャンバー内の水分、炭化水素、フルオロカーボンの汚染を低減しました。 |
|
表面クリーニング効果の可視化 |
|
UHVチャンバーに対するプラズマクリーニングの効果は、プラズマクリーニングの前後でUHVチャンバー内の残留ガスの組成を分析することで検証されています。プラズマクリーニング効果を可視化するために、厚い炭化水素の層で汚染された使用済みのRGAシールドグリッドをUHVチャンバー内に配置してプラズマクリーニングを行いました。表面の黒い炭素層は、RGAのフィラメントをオンにしたときにチャンバー内の炭化水素ガスとの低エネルギー電子解離によって堆積したものです。下記右側の写真がプラズマクリーニングを行った後のRGA部品です。これにより、酸素または酸素混合プラズマを用いたプラズマ・クリーニングが、真空チャンバー内の内部部品の表面に付着したカーボン汚染を効果的に除去できることが証明されました。 |
|
汚染されたRGAグリッドのプラズマクリーニング 左側:汚染されたグリッド 右側:プラズマクリーニング後 |
|
X線光電子分光法によるプラズマ表面クリーニング効果の評価 |
|
別の研究では、SEMI-KLEENプラズマソースがXPSシステムのロードロックチャンバーに設置されました。ステップ1では、XPSシステムがクリーンなInGaAsサンプル表面の組成を測定しました。ステップ2では、2秒間のリモート水素プラズマで試料をクリーニングした後、再びXPSシステムで表面を分析しました。水素プラズマによるクリーニングでは、表面に炭素や酸素による汚染はありません。ステップ3では、クリーニングしたInGaAsサンプルを周囲の空気に1時間さらしました。その後のXPS測定の結果、表面に炭素や酸素による汚染が見られた。ステップ4では、汚染されたInGaAsサンプルを再び水素プラズマで2秒間クリーニングしました。 |
|
|
|
このデータは、周囲の空気中に多くの炭化水素汚染があることを証明しています。したがって、チャンバーを周囲の空気でベントすると、チャンバーは炭化水素によって再び汚染されてしまいます。また、リモートプラズマクリーニングは、試料の表面やUHVチャンバー内の内部部品の表面に付着した汚染を効果的に除去できることを証明しています。 |
|
結論 |
|
最初の低真空ポンプダウンの直後にプラズマクリーニングのステップを追加することで、ポンプダウンの全体的な時間を大幅に短縮し、最終的な真空レベルを向上させることができます。プラズマで生成された高エネルギー粒子は、チャンバー内壁や内部部品の表面に吸着した水分、炭化水素、フルオロカーボンなどの汚れを叩き出すことができます。また、酸素ガスまたは酸素ガスの混合ガスで生成されたプラズマは、長鎖有機ポリマーを化学的に変換して、ポンプで排出しやすい高蒸気圧の副生成物にすることができます。また、プラズマクリーニング時の比較的高いガス流量により、UHVチャンバー内に閉じ込められた水分子をパージすることができます。また、真空ポンプ内に結露した水も取り除くことができます。 |
|
|